The Storm Riders
Writer
Để đáp ứng nhu cầu tích hợp ngày càng cao của các thiết bị bán dẫn, một công nghệ mới mang tính đột phá đang tiến gần đến giai đoạn triển khai quy mô lớn: Hybrid Bonding (Liên kết lai). Đây là kỹ thuật liên kết trực tiếp tấm wafer với nhau hoặc chip với wafer, hứa hẹn sẽ mở ra những tiềm năng to lớn, đặc biệt các thiết bị hiệu suất cao phục vụ Trí tuệ Nhân tạo (AI). Các công ty sản xuất bán dẫn theo hợp đồng (foundry) và các nhà sản xuất bộ nhớ đang tích cực thúc đẩy đổi mới công nghệ này, dự kiến giai đoạn phổ biến sẽ bắt đầu từ sau năm 2026.
Hybrid bonding là công nghệ liên kết trực tiếp các chip với nhau. Khác biệt hoàn toàn so với các phương pháp truyền thống như wire bonding (liên kết dây) hay flip-chip bonding, hybrid bonding cho phép kết nối trực tiếp tạo ra mật độ kết nối cực cao. Ưu điểm chính của phương pháp này là khả năng thu hẹp khoảng cách giữa các điện cực, dẫn đến tốc độ truyền dữ liệu nhanh hơn đáng kể. Điều này đặc biệt quan trọng trong việc tăng tốc độ truyền dữ liệu giữa bộ xử lý đồ họa (GPU) dùng cho AI và bộ nhớ băng thông rộng (HBM), từ đó đạt được hiệu suất tính toán vượt trội.
Hai phương pháp chính của hybrid bonding bao gồm "wafer-to-wafer (W2W)" (liên kết wafer với wafer) và "die-to-wafer (D2W)" (liên kết die chip với wafer). Trong đó, W2W đã được áp dụng và phát triển trong sản xuất bộ nhớ flash 3D NAND và cảm biến hình ảnh CMOS. Tuy nhiên, hướng đi được kỳ vọng sẽ tạo ra những đột phá lớn trong tương lai chính là D2W.

Trong lĩnh vực hybrid bonding cho HBM, SK Hynix của Hàn Quốc đang là một trong những đơn vị tiên phong. Công ty này có kế hoạch áp dụng hybrid bonding cho các thế hệ HBM có số lớp DRAM xếp chồng vượt quá 20 lớp. Hiện tại, HBM sử dụng các vias xuyên silicon (TSV) để tạo kết nối theo chiều dọc, khoảng trống giữa chúng được kết nối bằng các micro-bump. Việc áp dụng hybrid bonding sẽ loại bỏ sự cần thiết của các micro-bump này. HBM ngày càng tăng số lớp DRAM xếp chồng để nâng cao tốc độ xử lý dữ liệu. Tuy nhiên, việc tăng số lớp cũng làm tăng độ dày tổng thể, khiến các kỹ thuật đóng gói truyền thống không còn phù hợp. Hybrid bonding chính là giải pháp cho thách thức này.
Mặc dù tiềm năng là rất lớn, việc triển khai D2W không hề dễ dàng. Phó Giáo sư Fumihiro Inoue từ Đại học Quốc gia Yokohama, chuyên gia nghiên cứu về công nghệ đóng gói back-end, nhận định: "Đối với D2W, sự tích hợp kỹ thuật vẫn còn nhiều thiếu sót."
Lấy ví dụ về máy liên kết chip (die bonder): "Trước đây, việc liên kết được thực hiện bằng cách gia nhiệt. Với hybrid bonding, việc liên kết được thực hiện bằng plasma. Mặc dù các công ty đang nỗ lực phát triển công nghệ để thích ứng với sự thay đổi quy trình này, nhưng hiện tại đây vẫn chưa phải là một công nghệ hoàn thiện," Phó Giáo sư Inoue giải thích. Thêm vào đó, D2W đòi hỏi độ chính xác căn chỉnh (alignment) cực cao. Việc phải đảm bảo đồng thời cả sự thay đổi quy trình và độ chính xác căn chỉnh cao đã đẩy mức độ khó khăn kỹ thuật lên một tầm cao mới so với trước đây.
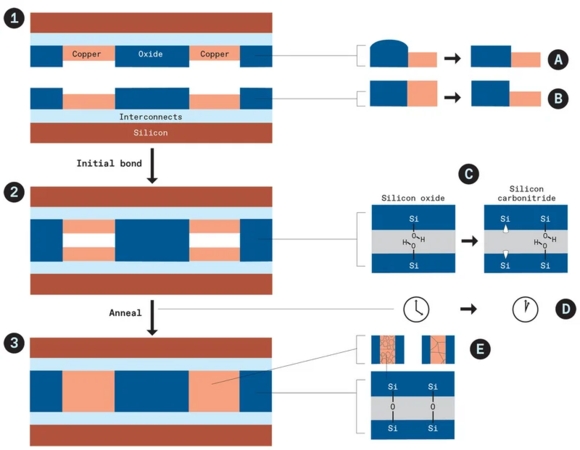
Tuy nhiên, Phó Giáo sư Inoue vẫn đặt nhiều kỳ vọng: "Công nghệ đóng gói back-end trước đây khá 'hoang dã'. Hybrid bonding lại là một công nghệ có nguồn gốc từ front-end. Do đó, nếu được hiện thực hóa, nó sẽ giúp thu hẹp khoảng cách công nghệ giữa front-end và back-end, tạo ra nhiều đột phá khác nhau." Để giải quyết các thách thức của D2W, một phương pháp khác đang được xem xét là "Reconstructed D2W" (D2W tái cấu trúc), tận dụng công nghệ W2W vốn đã trưởng thành hơn.
Quy trình Reconstructed D2W bao gồm việc liên kết trực tiếp chip lên một wafer mang (carrier wafer). Sau đó, các khoảng trống giữa các chip được lấp đầy bằng oxit và bề mặt liên kết lai được tạo ra bằng phương pháp đánh bóng hóa học-cơ học (CMP). Tiếp theo, bề mặt được xử lý bằng plasma và thực hiện hybrid bonding theo quy trình W2W. Cuối cùng, wafer mang được loại bỏ bằng phương pháp mài. Phương pháp này cho phép duy trì độ sạch cao đồng thời đạt được độ chính xác căn chỉnh tốt.
Phó Giáo sư Inoue nhận định: "Reconstructed D2W có lẽ là một giải pháp thực tế về mặt kỹ thuật. Đối với các công ty như TSMC của Đài Loan, việc có thể hoàn thiện toàn bộ quy trình tại cơ sở front-end của mình cũng mang lại lợi thế kinh doanh." TSMC hiện đang dẫn đầu về công nghệ sản xuất và các phương hướng thường trở thành tiêu chuẩn thực tế của ngành.
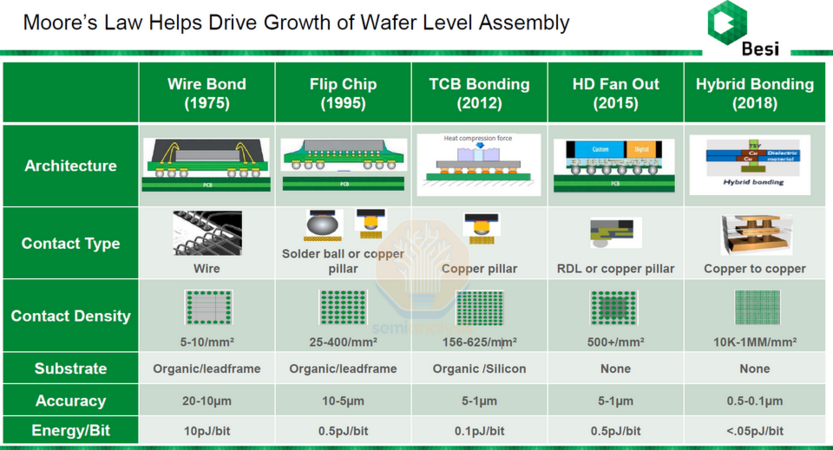
Các nhà sản xuất thiết bị cũng đang tích cực chuẩn bị cho kỷ nguyên hybrid bonding:
Hybrid bonding là công nghệ liên kết trực tiếp các chip với nhau. Khác biệt hoàn toàn so với các phương pháp truyền thống như wire bonding (liên kết dây) hay flip-chip bonding, hybrid bonding cho phép kết nối trực tiếp tạo ra mật độ kết nối cực cao. Ưu điểm chính của phương pháp này là khả năng thu hẹp khoảng cách giữa các điện cực, dẫn đến tốc độ truyền dữ liệu nhanh hơn đáng kể. Điều này đặc biệt quan trọng trong việc tăng tốc độ truyền dữ liệu giữa bộ xử lý đồ họa (GPU) dùng cho AI và bộ nhớ băng thông rộng (HBM), từ đó đạt được hiệu suất tính toán vượt trội.
Hai phương pháp chính của hybrid bonding bao gồm "wafer-to-wafer (W2W)" (liên kết wafer với wafer) và "die-to-wafer (D2W)" (liên kết die chip với wafer). Trong đó, W2W đã được áp dụng và phát triển trong sản xuất bộ nhớ flash 3D NAND và cảm biến hình ảnh CMOS. Tuy nhiên, hướng đi được kỳ vọng sẽ tạo ra những đột phá lớn trong tương lai chính là D2W.

Trong lĩnh vực hybrid bonding cho HBM, SK Hynix của Hàn Quốc đang là một trong những đơn vị tiên phong. Công ty này có kế hoạch áp dụng hybrid bonding cho các thế hệ HBM có số lớp DRAM xếp chồng vượt quá 20 lớp. Hiện tại, HBM sử dụng các vias xuyên silicon (TSV) để tạo kết nối theo chiều dọc, khoảng trống giữa chúng được kết nối bằng các micro-bump. Việc áp dụng hybrid bonding sẽ loại bỏ sự cần thiết của các micro-bump này. HBM ngày càng tăng số lớp DRAM xếp chồng để nâng cao tốc độ xử lý dữ liệu. Tuy nhiên, việc tăng số lớp cũng làm tăng độ dày tổng thể, khiến các kỹ thuật đóng gói truyền thống không còn phù hợp. Hybrid bonding chính là giải pháp cho thách thức này.
Mặc dù tiềm năng là rất lớn, việc triển khai D2W không hề dễ dàng. Phó Giáo sư Fumihiro Inoue từ Đại học Quốc gia Yokohama, chuyên gia nghiên cứu về công nghệ đóng gói back-end, nhận định: "Đối với D2W, sự tích hợp kỹ thuật vẫn còn nhiều thiếu sót."
Lấy ví dụ về máy liên kết chip (die bonder): "Trước đây, việc liên kết được thực hiện bằng cách gia nhiệt. Với hybrid bonding, việc liên kết được thực hiện bằng plasma. Mặc dù các công ty đang nỗ lực phát triển công nghệ để thích ứng với sự thay đổi quy trình này, nhưng hiện tại đây vẫn chưa phải là một công nghệ hoàn thiện," Phó Giáo sư Inoue giải thích. Thêm vào đó, D2W đòi hỏi độ chính xác căn chỉnh (alignment) cực cao. Việc phải đảm bảo đồng thời cả sự thay đổi quy trình và độ chính xác căn chỉnh cao đã đẩy mức độ khó khăn kỹ thuật lên một tầm cao mới so với trước đây.
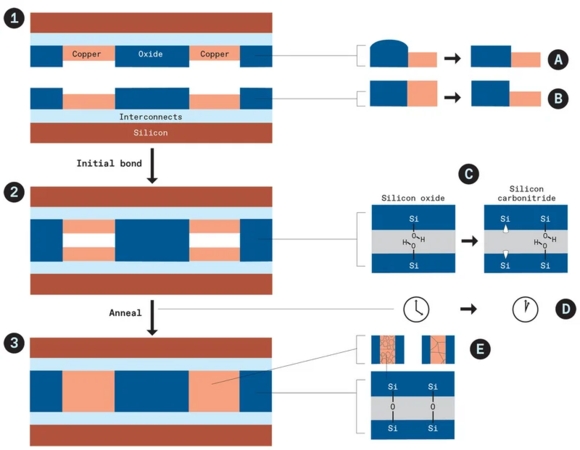
Tuy nhiên, Phó Giáo sư Inoue vẫn đặt nhiều kỳ vọng: "Công nghệ đóng gói back-end trước đây khá 'hoang dã'. Hybrid bonding lại là một công nghệ có nguồn gốc từ front-end. Do đó, nếu được hiện thực hóa, nó sẽ giúp thu hẹp khoảng cách công nghệ giữa front-end và back-end, tạo ra nhiều đột phá khác nhau." Để giải quyết các thách thức của D2W, một phương pháp khác đang được xem xét là "Reconstructed D2W" (D2W tái cấu trúc), tận dụng công nghệ W2W vốn đã trưởng thành hơn.
Quy trình Reconstructed D2W bao gồm việc liên kết trực tiếp chip lên một wafer mang (carrier wafer). Sau đó, các khoảng trống giữa các chip được lấp đầy bằng oxit và bề mặt liên kết lai được tạo ra bằng phương pháp đánh bóng hóa học-cơ học (CMP). Tiếp theo, bề mặt được xử lý bằng plasma và thực hiện hybrid bonding theo quy trình W2W. Cuối cùng, wafer mang được loại bỏ bằng phương pháp mài. Phương pháp này cho phép duy trì độ sạch cao đồng thời đạt được độ chính xác căn chỉnh tốt.
Phó Giáo sư Inoue nhận định: "Reconstructed D2W có lẽ là một giải pháp thực tế về mặt kỹ thuật. Đối với các công ty như TSMC của Đài Loan, việc có thể hoàn thiện toàn bộ quy trình tại cơ sở front-end của mình cũng mang lại lợi thế kinh doanh." TSMC hiện đang dẫn đầu về công nghệ sản xuất và các phương hướng thường trở thành tiêu chuẩn thực tế của ngành.
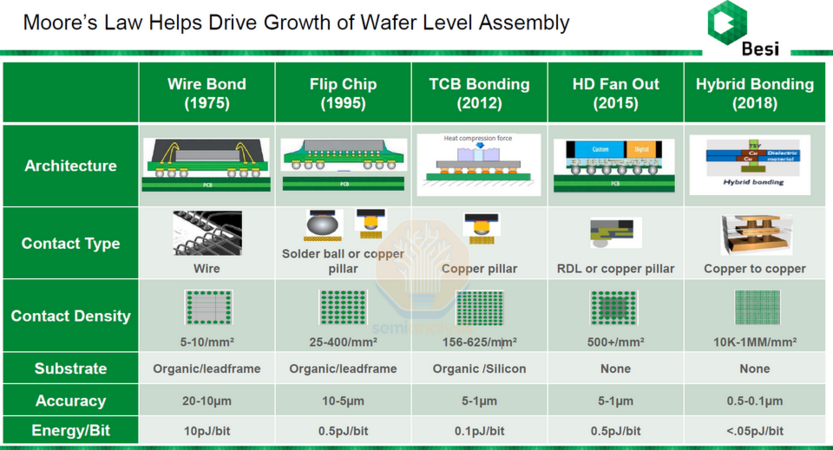
Các nhà sản xuất thiết bị cũng đang tích cực chuẩn bị cho kỷ nguyên hybrid bonding:
- DISCO: Chuẩn bị nhiều công nghệ cắt (dicing) khác nhau cho D2W hybrid bonding. Mặc dù việc quản lý độ sạch sẽ khó khăn hơn so với cắt thông thường, DISCO tự tin: "So với front-end, yêu cầu không quá khắt khe. Chúng tôi đã tích lũy công nghệ từ khoảng năm 2008, nên rào cản không quá lớn." Ba công nghệ cắt chính chuẩn bị bao gồm "plasma dicing" (sử dụng phản ứng hóa học), "dicing before grinding (DBG)" (phù hợp với việc làm mỏng wafer) và "laser dicing". Công ty khẳng định "về mặt kỹ thuật đã sẵn sàng" và sẽ "chuẩn bị tất cả các công nghệ cần thiết để khách hàng có thể đưa ra lựa chọn hài lòng nhất."
- Tokyo Electron (TEL): Đã tung ra thị trường thiết bị liên kết cho W2W và đang tiếp tục phát triển công nghệ liên kết cho D2W. TEL đang gặt hái thành công với các giải pháp cho HBM, tận dụng thế mạnh công nghệ front-end của mình cho cả quy trình back-end.
- EV Group (Áo): Đã hợp tác với các nhà sản xuất máy liên kết chip để giới thiệu thiết bị cho D2W. Từ năm 2020, công ty đã thành lập "Trung tâm Năng lực Tích hợp Không đồng nhất" (Heterogeneous Integration Competence Center) với sự tham gia của các đối tác. Chủ tịch Hiroshi Yamamoto EV Group Nhật Bản giải thích: "D2W làm tăng tính linh hoạt trong thiết kế và sản xuất. Các nhà sản xuất thiết bị và vật liệu buộc phải chuẩn bị nhiều phương pháp khác nhau." Trong tương lai, EV Group sẽ "thúc đẩy chiến lược cung cấp giải pháp toàn diện, không chỉ thiết bị liên kết mà còn cả thiết bị kiểm tra, thiết bị tách lớp, v.v..."









