Vũ Nguyễn
Writer
Công nghệ đóng gói EMIB (Embedded Multi-die Interconnect Bridge) đang trở thành một trụ cột quan trọng trong chiến lược của Intel khi hãng tìm cách cạnh tranh trực tiếp với TSMC trong lĩnh vực đóng gói bán dẫn tiên tiến. Thay vì sử dụng một interposer lớn như cách tiếp cận truyền thống, EMIB dùng các cầu nối silicon nhỏ được nhúng trực tiếp vào chất nền để liên kết nhiều khuôn chip với nhau. Nhờ vậy, nó vừa giảm chi phí vừa cho phép mở rộng linh hoạt, đặc biệt phù hợp với các hệ thống AI và trung tâm dữ liệu hiện đại.
Trong bối cảnh nhu cầu tính toán AI bùng nổ, EMIB nổi lên như một giải pháp thay thế đáng chú ý cho công nghệ CoWoS của TSMC. Điểm mạnh của EMIB nằm ở khả năng tích hợp nhiều loại chip khác nhau, từ logic đến bộ nhớ băng thông cao (HBM), mà không bị phụ thuộc vào một quy trình sản xuất cụ thể. Điều này giúp các công ty lớn như Google hay Nvidia có thể linh hoạt thiết kế các bộ xử lý AI thế hệ mới. Ngay cả Meta cũng được cho là đang lên kế hoạch sử dụng EMIB cho các sản phẩm trong tương lai.
Một tín hiệu tích cực đến từ tỷ lệ sản xuất. Theo nhà phân tích Jeff Pu, yield của EMIB đã đạt khoảng 90%, một con số rất cao trong ngành bán dẫn. Điều này cho thấy công nghệ đã đủ trưởng thành để triển khai ở quy mô lớn, đồng thời củng cố niềm tin của Intel vào mảng sản xuất chip theo hợp đồng.
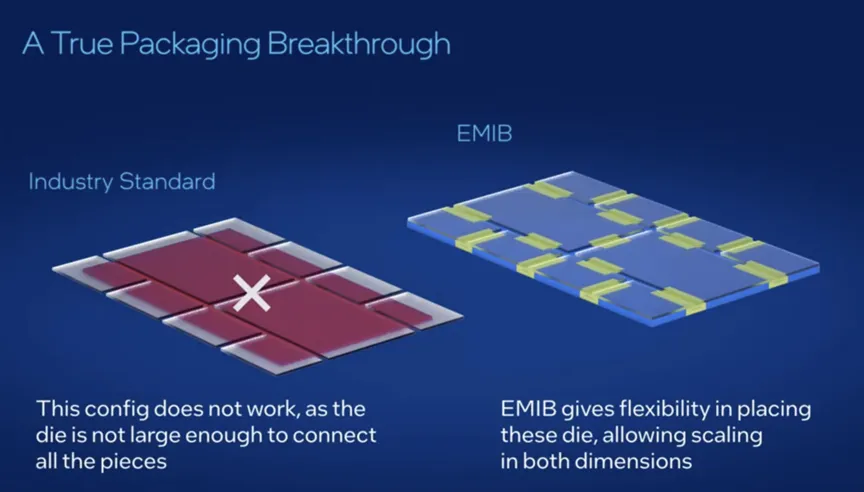
So với công nghệ đóng gói quen thuộc như FCBGA, EMIB mang lại mật độ kết nối cao hơn nhiều. Trong khi FCBGA gắn chip trực tiếp lên bảng mạch thông qua các bóng hàn, EMIB cho phép nhiều chip giao tiếp với nhau thông qua các cầu nối tốc độ cao được đặt ngay trong gói, từ đó cải thiện hiệu năng và hiệu quả năng lượng.
Intel hiện phát triển hai biến thể chính của công nghệ này. EMIB-M tập trung vào việc nâng cao hiệu suất và độ ổn định bằng cách sử dụng tụ MIM capacitor trong cầu nối silicon, giúp giảm nhiễu và cải thiện cấp nguồn. Trong khi đó, EMIB-T được thiết kế cho các hệ thống AI hiệu năng cao, tích hợp công nghệ TSV để cho phép cấp điện trực tiếp qua cầu nối thay vì đi vòng, từ đó tăng mật độ và khả năng mở rộng.
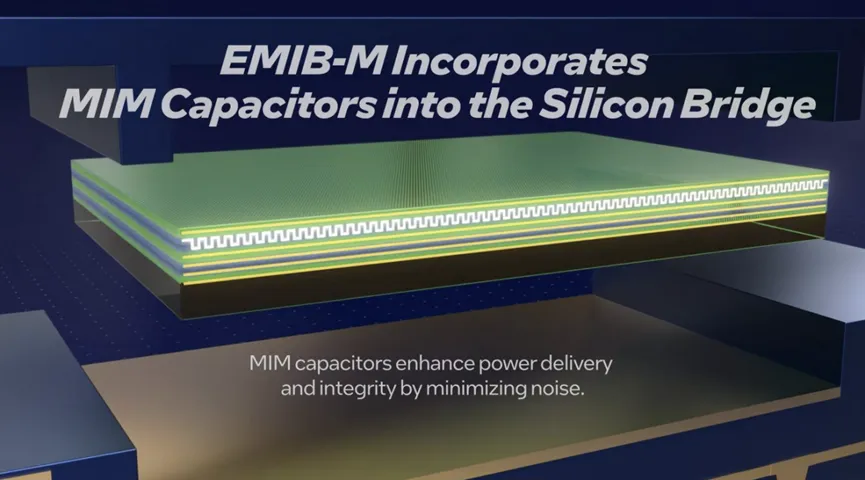
Khả năng mở rộng chính là điểm khiến EMIB trở nên đặc biệt hấp dẫn. Các thiết kế hiện tại đã có thể đạt kích thước gói rất lớn và tích hợp nhiều chip HBM cùng lúc. Trong vài năm tới, Intel kỳ vọng sẽ tiếp tục mở rộng giới hạn này, cho phép tạo ra những hệ thống đa chip khổng lồ phục vụ các trung tâm dữ liệu siêu quy mô. Trong khi đó, TSMC cũng đang phát triển các công nghệ như System-on-Wafer với khả năng tích hợp rất lớn, nhưng đi kèm chi phí cao hơn đáng kể.
EMIB không chỉ là một cải tiến kỹ thuật mà còn là bước đi chiến lược của Intel. Nhờ khả năng kết hợp nhiều công nghệ, tối ưu chi phí và mở rộng linh hoạt, nó đang trở thành nền tảng quan trọng cho thế hệ chip AI tiếp theo, đồng thời giúp Intel thu hẹp khoảng cách với các đối thủ trong cuộc đua đóng gói bán dẫn tiên tiến.
Trong bối cảnh nhu cầu tính toán AI bùng nổ, EMIB nổi lên như một giải pháp thay thế đáng chú ý cho công nghệ CoWoS của TSMC. Điểm mạnh của EMIB nằm ở khả năng tích hợp nhiều loại chip khác nhau, từ logic đến bộ nhớ băng thông cao (HBM), mà không bị phụ thuộc vào một quy trình sản xuất cụ thể. Điều này giúp các công ty lớn như Google hay Nvidia có thể linh hoạt thiết kế các bộ xử lý AI thế hệ mới. Ngay cả Meta cũng được cho là đang lên kế hoạch sử dụng EMIB cho các sản phẩm trong tương lai.
Một tín hiệu tích cực đến từ tỷ lệ sản xuất. Theo nhà phân tích Jeff Pu, yield của EMIB đã đạt khoảng 90%, một con số rất cao trong ngành bán dẫn. Điều này cho thấy công nghệ đã đủ trưởng thành để triển khai ở quy mô lớn, đồng thời củng cố niềm tin của Intel vào mảng sản xuất chip theo hợp đồng.
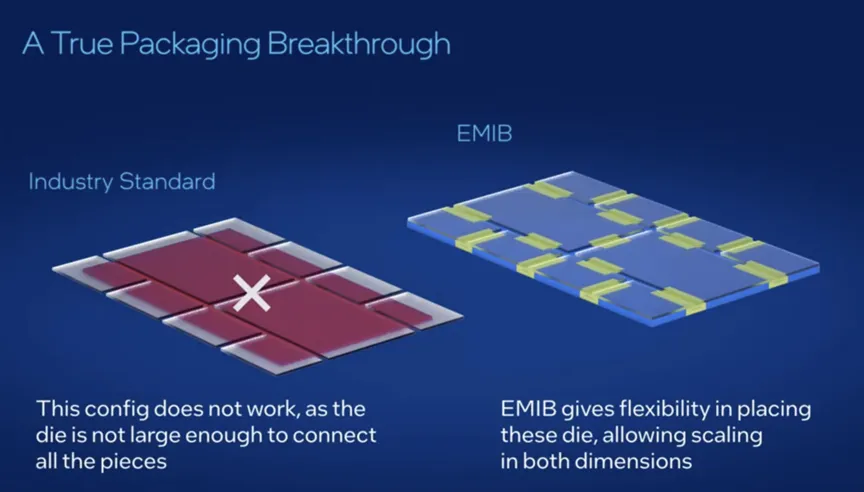
So với công nghệ đóng gói quen thuộc như FCBGA, EMIB mang lại mật độ kết nối cao hơn nhiều. Trong khi FCBGA gắn chip trực tiếp lên bảng mạch thông qua các bóng hàn, EMIB cho phép nhiều chip giao tiếp với nhau thông qua các cầu nối tốc độ cao được đặt ngay trong gói, từ đó cải thiện hiệu năng và hiệu quả năng lượng.
Intel hiện phát triển hai biến thể chính của công nghệ này. EMIB-M tập trung vào việc nâng cao hiệu suất và độ ổn định bằng cách sử dụng tụ MIM capacitor trong cầu nối silicon, giúp giảm nhiễu và cải thiện cấp nguồn. Trong khi đó, EMIB-T được thiết kế cho các hệ thống AI hiệu năng cao, tích hợp công nghệ TSV để cho phép cấp điện trực tiếp qua cầu nối thay vì đi vòng, từ đó tăng mật độ và khả năng mở rộng.
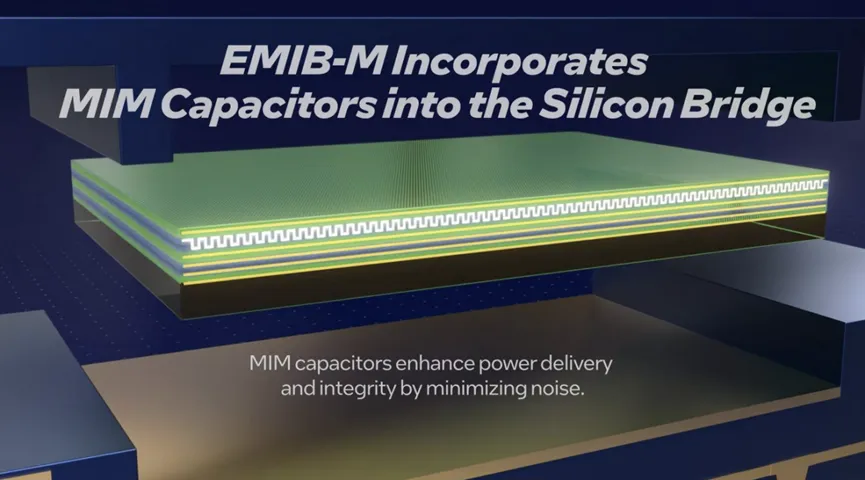
Khả năng mở rộng chính là điểm khiến EMIB trở nên đặc biệt hấp dẫn. Các thiết kế hiện tại đã có thể đạt kích thước gói rất lớn và tích hợp nhiều chip HBM cùng lúc. Trong vài năm tới, Intel kỳ vọng sẽ tiếp tục mở rộng giới hạn này, cho phép tạo ra những hệ thống đa chip khổng lồ phục vụ các trung tâm dữ liệu siêu quy mô. Trong khi đó, TSMC cũng đang phát triển các công nghệ như System-on-Wafer với khả năng tích hợp rất lớn, nhưng đi kèm chi phí cao hơn đáng kể.
EMIB không chỉ là một cải tiến kỹ thuật mà còn là bước đi chiến lược của Intel. Nhờ khả năng kết hợp nhiều công nghệ, tối ưu chi phí và mở rộng linh hoạt, nó đang trở thành nền tảng quan trọng cho thế hệ chip AI tiếp theo, đồng thời giúp Intel thu hẹp khoảng cách với các đối thủ trong cuộc đua đóng gói bán dẫn tiên tiến.










